 298
298
 2025-04-24
2025-04-24
中国粉体网讯 半导体封装,指用特定材料、工艺技术将芯片密封在塑料、金属或陶瓷等材料制成的封装体内,从而保护芯片免受物理性和化学性损坏,通过封装,还可以使芯片能够与其他电子元件进行连接,实现信息的输入输出。半导体封装主要有机械保护、电气连接、机械连接和散热四大功能,芯片封装完成后,需要进行性能测试,以确保封装的芯片符合性能要求。
半导体封装的四大作用
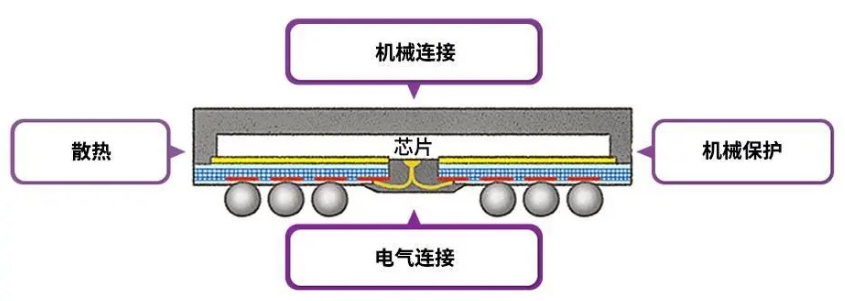
来源:海力士官网、HANOL出版社、山西证券研究所
LTCC和HTCC应用:各有所长
现今集成电路晶圆的特征线宽进入微纳电子时代,而电子产品和电子系统的微小型化依赖先进电子封装技术的进步,封装技术已成为半导体行业关注的焦点之一。
LTCC和HTCC是两种重要的半导体封装技术,广泛应用于半导体芯片封装、MCM和SiP模块制造。
LTCC封装能将不同种类的芯片等元器件组装集成于同一封装体内以实现系统的某些功能,是实现系统小型化、集成化、多功能化和高可靠性的重要手段;HTCC技术在制作高精度、高密度的多层布线方面也具有较强的能力,能够满足半导体封装对精细电路布局的需求。

LTCC技术和HTCC技术对比
LTCC即低温共烧结陶瓷,LTCC基板具有布线导体方阻小、可布线层数多、布线密度高、烧结温度低、介质损耗小、高频性能优异、热膨胀系数与多种芯片匹配等优点,因而成为一种理想的高密度集成用主导基板。

LTCC金属外壳封装基板样品
HTCC即高温共烧结陶瓷,HTCC基板具有机械强度高、化学性能稳定、布线密度高等诸多优点,广泛应用于高可靠、高集成度的微系统封装。提高陶瓷基板的布线密度、缩小陶瓷基板的最小特征尺寸不仅能提高陶瓷封装密度,而且有利于进一步提高微系统的集成度。在电子封装领域,多层高温共烧氧化铝陶瓷外壳与薄膜封装基板由于各自的特点都有较为广泛的应用。
优势多多,机遇多多
随着电子产品向小型化、轻量化、高性能化方向发展,半导体封装技术面临着前所未有的挑战与机遇。
电气性能优势。LTCC的陶瓷材料具有优良的高频高Q特性,能够有效减少信号传输过程中的损耗和失真,特别适合用于高频通信领域的半导体封装。HTCC的低介电常数和低介电损耗特性,使其在高速信号传输方面表现出色。在高性能计算芯片封装中,HTCC能够降低信号传输延迟,提高芯片的运算速度和数据处理能力,满足大数据处理和人工智能运算对芯片性能的苛刻要求。
热性能优势。LTCC技术制备的产品具有较好的热传导性,能够快速将芯片产生的热量散发出去,有效降低芯片的工作温度。HTCC技术由于其高温烧结形成的致密结构,具有优异的热稳定性,能够在高温环境下保持封装性能的稳定。
集成化优势。LTCC技术能够将多种无源元件,如电容、电阻、电感等,以及芯片集成在一个封装内,减少了外部连接线路,提高了电路的集成度和可靠性;HTCC技术同样具备良好的集成化能力,能够在多层陶瓷基板上实现高密度的布线和芯片集成。
LTCC和HTCC仍面临众多挑战
LTCC技术的工艺过程较为复杂,涉及多个精细的步骤,这给其大规模应用带来了一定的挑战。首先,我国在高频低损耗低温共烧陶瓷介质材料生产方面依然落后于国外发达国家,目前我国LTCC瓷粉批次稳定性差,没有量产能力,与银电极浆料材料匹配性差,因此,国产瓷粉的需求量也不足,不能形成规模生产。在高性能LTCC陶瓷粉和生瓷带方面,尤其是5G通信器件应用的材料目前在国内近乎空白。其次,专用设备的缺乏,使得生产成本不断攀升。
HTCC技术的高温烧结工艺是其面临的主要挑战之一,在1600℃左右的高温下进行烧结,对设备的要求极高,不仅需要专门的高温烧结炉,而且设备的维护成本和能耗都较高。同时,因其共烧温度较高,使得金属导体材料的选择受限,而且会大大增加其成本。此外,高温环境下对陶瓷基板与金属化层之间的结合强度也有较高的要求,如果结合不牢固,在后续的使用过程中可能会出现金属化层脱落等问题,降低封装的可靠性。
LTCC和HTCC技术凭借其在电气性能、热性能和集成化等方面的显著优势,在半导体封装领域迎来了诸多机遇,尤其是在高性能计算芯片、5G 通信芯片以及传感器芯片等封装应用中展现出巨大的潜力。然而,不可忽视的是,这两种技术在工艺复杂性、成本以及与其他封装技术的竞争等方面面临着严峻的挑战。
中国粉体网将于2025年5月13日在江苏昆山举办“第四届半导体行业用陶瓷材料技术大会”,届时,来自中国电子科技集团公司第二研究所的高级工程师陈晓勇将带来题为《LTCC和HTCC在半导体封装中面临的机遇与挑战》的报告,报告将重点阐述其在LTCC工艺方面所取得科研成果,梳理了目前LTCC材料国产化进程,同时汇报在HTCC技术方面取得的进展情况。面对人工智能、大数据、5G/6G移动通信和新能源等需求牵引和先进封装技术迭代带来的市场冲击,LTCC和HTCC将面临巨大的机遇与挑战,并展望未来LTCC/HTCC技术发展方向。

报告老师简介
陈晓勇,高级工程师,中国电子科技集团公司第二研究所制造部专家。多年来从事 LTCC 和 HTCC 工艺技术及封装技术研究,承担多项重点型号产品的研制工作,具有丰富的多层陶瓷产品开发及生产经验,参与编制多项多层共烧陶瓷行业标准。
来源:
于斐等:基于HTCC和薄膜工艺的微系统封装基板制备技术
李建辉等:LTCC封装技术研究现状与发展趋势
(中国粉体网编辑整理/空青)
注:图片非商业用途,存在侵权告知删除

2025-04-22
2025-04-22
2025-04-22
2025-04-21
2025-04-19
2025-04-19
2025-04-18
2025-04-17